1、Plasma:广泛应用而又复杂的物理过程
等离子体刻蚀在集成电路制造中已有40余年的发展历程,最早70年代引入用于去胶,80年代成为集成电路领域成熟的刻蚀技术。刻蚀采用的等离子体源常见的有容性耦合等离子体(CCP-capacitivelycoupledplasma)、感应耦合等离子体ICP(Inductivelycoupledplasma)和微波ECR等离子体(microwaveelectroncyclotronresonanceplasma)等。
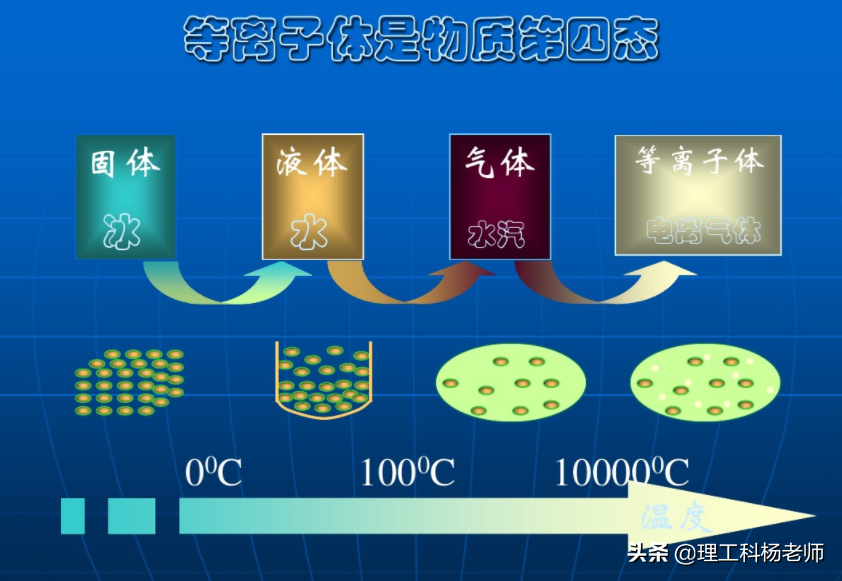
虽然等离子体刻蚀设备已广泛应用于集成电路制造,但由于等离子体刻蚀过程中复杂的物理和化学过程到目前为止仍没有一个有效的方法完全从理论上模拟和分析等离子体刻蚀过程。除刻蚀外,等离子体技术也成功的应用于其他半导体制程,如溅射和等离子体增强化学气相沉积(PECVD)。当然鉴于plasma丰富的活性粒子,plasma也广泛应用于其他非半导体领域,如空气净化,废物处理等。
由于刻蚀过程中复杂的物理和化学反应,不同中性粒子、带电粒子间的场(电场,流场,力场等)的相互作用,使得plasma刻蚀很难描述。如下图形象化的等离子球磨技术示意:

下面我们将简单的介绍常用的几种等离子体刻蚀技术。
2、容性耦合等离子体(CCP)
等离子体是部分离化的中性气体,在等离子体中自由电子与中性分子,原子进行碰撞,通过碰撞电离,进一步得到更多的电子和离子。基于电子的能量,可以获得更丰富的离子,激发态高能中性粒子等,同时由于电子吸附在中性气体表面还可获得负离子。由于每种气体在原子分子物理学中有各自的能级结构,故高能电子可以将气体激发到不同的能级上,当气体分子、原子从高能级向低能级回迁时将会辐射出不同能量的光子,不同能量的光子代表了不同的波长,通过分析光谱我们可以有效地分析等离子体的刻蚀过程。该分析诊断过程常被用于半导体制造中的EDP监测。
容性耦合等离子体源典型的腔室结构如下图。功率加载到上下电极上,射频率为60MHZ。所谓的暗鞘层将在所有器壁表面形成,暗鞘层常被认为是绝缘体或电容,因此可以认为功率通过一个电容器转移至等离子体。
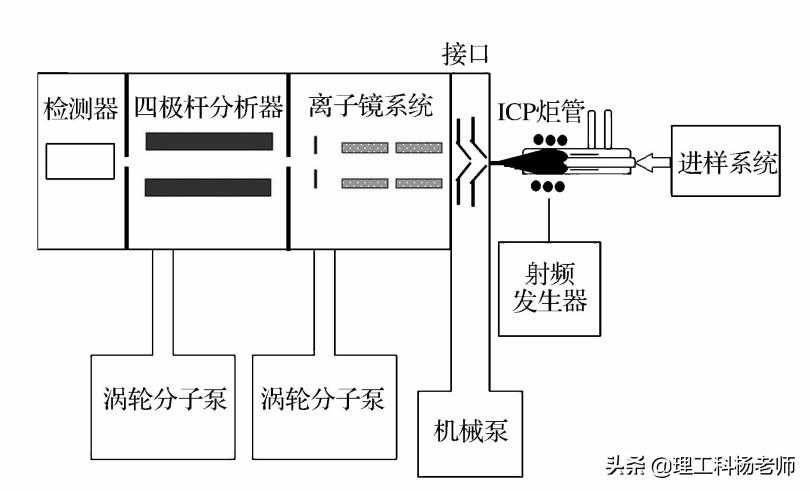
在频率为1MHz和100MHz之间,自由电子可以伴随电场的变化获得能量,离子由于质量较重,往往不会伴随变化的电场运动。
容性耦合等离子体放电气压范围往往从几个毫托到几百毫托,因为电子质量远低于离子质量,电子可以运动更远更长的距离并与气体和器壁进行碰撞,电离出更多的电子和离子。而器壁周围因为电子游离只留下笨重的离子,但整个腔室必须保证电中性,故必然会在器壁形成一种结构来阻挡电子继续在器壁周围的电离,而这种结构最终平衡了等离子体的电中性特性。这种结构即鞘层,鞘层可认为前面所说的电容器,因为电容器处于放电环境中,表面有电荷积累,就形成了一个电场,一个电场必然对应一个电压,因为电容器周围达到的电荷积累动态平衡,故这个电场,电压为动态的静电场,即直流电场和直流电压,故VDC形成。因为腔室内壁接地,而形成的偏压电场为阻止电子,故对地内壁而言此VDC为负值,即负偏压。在电极上此负偏压与射频电压一起形成了复合电压,如下图。
2.1影响VDC因素
2.1.1反应腔的尺寸和刻蚀模式
2.1.2等离子体参数
1)气体和流量
电负性气体是一个主要因素,当其他过程参数保持一定时,气体的电负特性将决定VDC。地电负性气体如O2,N2有较高的负偏压VDC,含F,Cl,Br的气体有更强电负性,因为VII族的元素很容易吸附自由电子。因子在含F,Cl,Br的气体中电子密度会大大降低。含F比含Cl气体电负性更强,SF6为典型的电负性气体。
气体流量通常对VDC没有较大影响,但是如果用混合气体,当气体的相对流量增加时,VDC单调的增加,通常,当加入弱电负性气体时,负偏压将会急剧增加。对于电负性气体放电,小的流量变化对VDC影响也不大。
2)气压
气压也影响VDC,高气压,更多的分子、原子与电子碰撞,产生新的电子和离子,因此通过提高气压,增加更多的自由电子,提高了负偏压。另一方面,气压增加,密度增加,电子的平均自由程降低,在和分子碰撞之前,电子获得能量减小,导致新的电子、离子减少。因此两个方面相反的趋势,对于等离子体刻蚀,可以看到,1-100mT范围内,等离子密度随气压增加而增加,但更高的气压,密度随气压增加而降低。VDC也与自由电子能量相关,高气压,电子碰撞增加,电子能量因碰撞而降低。考虑到这些机制,我们可以理解VDC随气压增加并不会持续增加。
3)功率
功率的影响最直接,功率增加,密度和电子能量都增加,因此VDC增加;
结论
当Wafer放置在下电极上,可以在等离子体和Wafer之间得到较高的电压降即VDC。当电负性气体添加时,在低气压下,我们可以获得高的电压降VDC,对于高功率,RIE反应离子刻蚀,我们可以通过以上途径获得高VDC。如果要获得低的VDC则从反方向条件着手。
2.2刻蚀机制
刻蚀机理的解释适用于所有类型的等离子体技术,不局限于RIE。
通常,等离子体刻蚀是化学刻蚀,不是物理刻蚀,这意味着固体原子与气体原子反应形成化学分子,然后从基片表面移除形成刻蚀。因为VDC的存在,通常存在一定的基片溅射,对于大量的刻蚀,物理刻蚀效应很弱可以被忽略。
几个主要的刻蚀过程为:
1.形成反应粒子;
2.反应粒子到达Wafer表面并被吸附
3.Wafer表面化学吸附反应,形成化学键,并形成反应产物;
4.解吸附化学反应产物,并在Wafer表面移除,抽离腔室;
举例:SF6+e—SF5+F+e;SF5+e—SF4+F+e;等等
F原子到达基片与基片反应F+Si—SiF,SiF+F—SiF2;SiF+SiF—SiF4
2.3VDC对刻蚀的影响
1.刻蚀速率,因为电子密度和能量与VDC相关联,故以上的化学反应过程与速率相对应;
2.离子轰击造成Wafer表面损伤;而离子轰击的能量与VDC相关,VDC越高轰击越强;
3.离子轰击还会对刻蚀形貌有一定的影响等等
4.对于非易挥发性副产物,通过一定的离子轰击可以将副产物解离形成易挥发性产物,使本身在易在Wafer表面已形成的膜层消失;
对于VDC主要会加速离子对Wafer表面的作用,根据不同的工艺需求,调节VDC可以调节对Wafer的刻蚀。
3、感应耦合等离子体(ICP)
两种类型的感应耦合等离子体源:采用柱形和平面结构,如下图所示。射频电流流经线圈在腔室内产生电磁场激发气体产生等离子体,偏压源控制离子轰击能量。通过这种方式,可以独立的控制等离子体密度和离子的轰击能量。因此ICP刻蚀机提供了更多的调控手段。
用于等离子体刻蚀的ICP源通常为平面结构,该方式容易获得可调的等离子体密度和等离子体均匀性分布,此外平面ICP源使用的介质窗也易于加工。石英和陶瓷是常用的介质窗材料。
此外感应耦合ICP源也存在容性耦合,介质窗作为线圈和等离子体之间的耦合层是作为一个电容器存在,在线圈的输出端电压达到2000V时,容性耦合将会形成。这个容性高压可以点燃和维持等离子体放电,另一方面,局部高压的形成会导致介质窗的刻蚀,导致颗粒的产生或者造成晶圆的污染。为减小容性耦合,采用法拉第屏蔽或者在线圈末端串联接地电容的方式。
-
简易功放电路DIY,教大家做一款音质还不错的功放,你学会了吗?
2025-04-01 -
安培小时计的自动加药设置
2024-12-01 -
全球电子垃圾激增亟需关注(环球热点)
2025-03-14 -
酷睿?至强?锐龙?Intel&AMD CPU系列含义解读
2025-01-08




